0755-89361696
136-9222-2061
圆晶切割(划片)的过程中最容易发生的问题:空切和碎屑
㈠ 空切
空切发生的原因:
◆ 粘着面不清洁
※解决方法:
一般使用者遇到空切的问题时,通常都只考虑到粘力不足,不常考虑到圆晶片背面与基板贴合面的状态,清洗贴合面有助于增加胶带的贴合面,通常使用的清洗方法大致有两种:
① 超声波清洗
② 电解清洗
◆ 胶带与被粘着面粘力不足。
※分析:
通常粘力=(胶带与晶片的接触面积)×(胶带对晶圆或基板背面的粘度)
所以当晶片越小,或是胶带粘度低时会产生空切的机会就越多。
针对空切的解决方法:
① 选用粘度较大而解卷力又不太高的胶带。
② 增加胶带与晶片背面的接触面积(贴合之后固化)。
为了增加胶带与晶圆的接触面积,可分为预固化(预热)与贴合之后烘烤两种:
预固化:在贴合之前利用晶圆夹具台加温,达到胶带贴合到晶圆时胶带的胶层稍微软化,达到较好的贴合效果。
贴合之后的烘烤:预固化的效果没有达到的需要的粘力,所以用此方法,预防在划片过程中发生空切现象。
晶圆由于在背面研磨后有TTV值的存在,并非百分之百的平面,用烤箱烘烤使胶层软化,以达到填充晶圆背面的微小凹面,使胶带与晶圆背面的接触面增加,以达到增加粘力的效果。
当胶层温度由由低到高时,胶层的粘度变小,但胶的流动性变大,使胶层比较容易渗入不平整的晶圆背面,以增加接触面积,当晶圆要切割之前,胶层又回到原来的温度,因为胶对温度的变化是一种不可逆的过程。
由于并非长时间烘烤,粘度并不会大幅改变,主要改变粘力的因素在于胶带与晶圆的接触面积的增加。

用烘烤的方法增加粘力,基本上有一些限制,当胶带贴合到矽晶圆的背面后以60 ℃热源烘烤三分钟其胶带与晶圆的接触面积已经达到80%以上,此时若再继续烘烤十分钟最多增加10%,所以我们可以得出结论,虽然烤的越久,胶带与晶圆的接触面积增加越多所以越粘,但后面的烘烤时间也会越没效率。
烘烤的目的就是要增加粘性,对解决空切而言当然越粘越好,但对于晶片粘合而言, 胶带越粘,顶针的力量就越大,对晶圆背面留下的伤痕的机会也越大,所以建议使用晶圆切割胶带时,如果晶片的尺寸小于2mm×2mm,或是有如上述顶针刮痕的问题,建议使用UV膜胶带。
㈡ 碎屑
碎屑大约可分为:
(1)上面碎屑(2)背面碎屑(3)边角碎屑(4)破裂碎屑
发生碎屑的原因大致可分为三大因素:
▲刀具因素 ▲晶圆材料的因素 ▲胶带因素
▲ 刀具因素
① 切割速度越快
② 刀具主轴转速越快
③ 晶片越小
④ DI 水喷的越少
▲ 晶圆材料的因素
① 有钝化的晶圆会比镜面晶圆较容易发生碎屑;
② 较薄的晶圆较容易发生碎屑;
※这里主要针对胶带因素来讲讲:
▲ 胶带因素
1、碎屑的位置:
一般碎屑发生时应该都会在晶片的同一边,对晶片而言,第4个切割边常是最容易发生碎屑的地方。
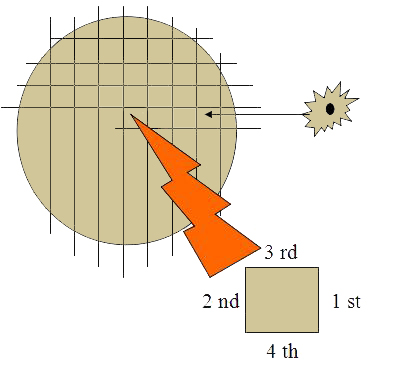
主要原因为:
(1)其切割地方的前方已经存在切割线。
(2) 对晶片而言,切割边就是最后一个支撑边,如果没有很优良的胶带做为切割平台, 晶圆很容易发生碎屑。
2、胶带的制造误差
制造误差越小,胶带的表面越平整,碎屑的问题就越小。
解决方法:如果使用一般的胶带,那么建议使用电子级的胶带。
3、刀具切入胶带的深度
基本上刀具穿晶圆后,切入胶带的深度越大,越不容易碎屑,但是也不能切的太深。
※解决方法:
⊙ 使用胶带厚度较厚,同样是PVC基材的胶带。
⊙ 使用相同厚度的胶带,但其基材必须为不可扩展的胶带。
⊙ 切割平台
圆晶切割(划片)时会碎屑的现象,除了以上原因外,最重要的原因在于划片过程中如何保持晶片不受移动是非常重要的,胶层太软,容易使晶片在划片过程中晃动而产生碎屑。
因为胶层紧贴着晶圆,在划片过程中,胶层的作用就等于的切割平台。所以提高胶层硬度,使切割平台够硬,碎屑问题就会改善。