0755-89361696
136-9222-2061
晶圆研磨胶带,是在研磨硅片背面,用于保护硅片正面(带电路的面)的胶带。以不需洗浄工程的粘着制没十力理念,兼具低微坐性,以及稳定的削研性。背面研磨胶带(一般蓝膜系列)概要贴背研磨胶带被用于在对晶圆的背面进行研削(贴背研磨)时,保护电路面以回避外界异物所造成的损伤,崩裂、裂纹(开裂)以及脏污等的污染。随着晶圆的大口径化、薄型化以及高凸块设计的开发,对胶带所要求的主要特点为:
①低污染、
②对晶圆的追从性、
③容易剥离这些方面。ELEGRIPTAPE满足这些要求事项,再加上由于它是非水溶性型,耐水环境,不需要进行清洗。特征
对电路面等凸凹的晶圆具有优良的粘附性
防止尘埃的发生
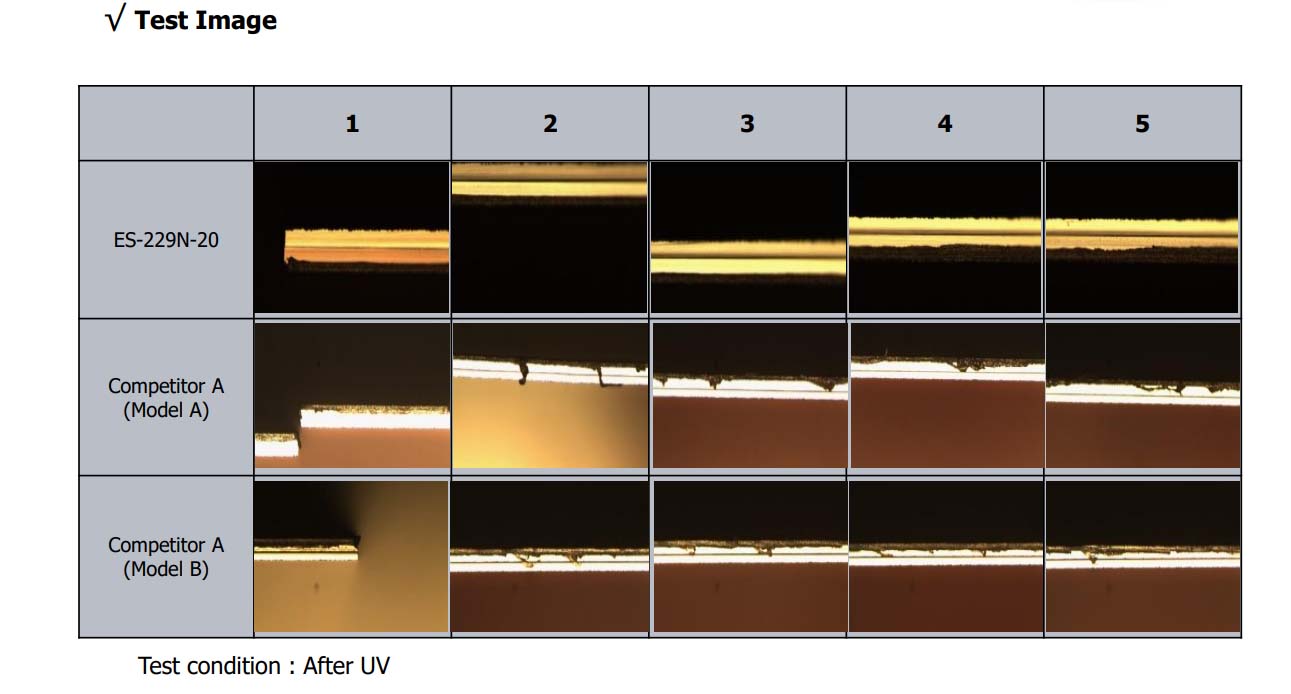
对背面进行研削时,对水环境具有超群的研削精度(TTV)
晶圆研磨用保护胶带依次包含基材层、填充层、粘合剂层和离型膜层;按重量份计,填充层的制备原料由改性木质素嵌段共聚聚醚多元醇4060份、异氰酸酯1020份、发泡催化剂15份和水510份组成;其中改性木质素嵌段共聚聚醚多元醇是由长链烷基酚和苯酚对木质素进行协同改性,得到改性木质素,将改性木质素与聚醚多元醇在活化剂存在下,共聚反应生成至少包含一种长链烷基残基、苯酚残基和至少一种多元醇残基的嵌段共聚物。本发明的保护胶带,有效填充晶圆表面的高低落差,并且经过改进的聚氨酯填充层的刚性和柔软性能够很好的进行平衡,确保保护胶带厚度均匀,防止减薄后的晶圆厚度不均匀。
半导体产品的小型薄型化是现今的趋势,集成电路的量产工艺中,缩减尺寸的方法之一为采用极薄半导体晶片,另一种方法采用背面研磨方法以缩减半导体晶片的厚度。因此,在晶圆上集成电路制作工序之后和晶圆切割工序之前,还包括有晶圆背面研磨工序,以使得晶圆上多个晶片能够一次完成薄化处理。